文章大綱
2024年台股 CoWoS 概念股有哪些?
2024 年台股 CoWoS 相關的概念股如下:
CoWoS 封裝:台積電(2330)、日月光投控(3711)
研磨工具:中砂(1560)
EUV 光罩盒:家登(3680)
揀晶設備:萬潤(6187)
IC 載板:欣興(3037)
PCB 基板:楠梓電(2316)
| 產品 | 個股名稱 | 股價(元) | 本益比(倍) |
|---|---|---|---|
| CoWoS 封裝 | 2330 台積電 | 940 | 28.40 |
| CoWoS 封裝 | 3711 日月光投控 | 155.5 | 21.60 |
| CoWoS 封裝 | 3374 精材 | 229.5 | 42.30 |
| CoWoS 測試 | 2449 京元電子 | 106.5 | 21.60 |
| 研磨工具 | 1560 中砂 | 322 | 50.20 |
| EUV 光罩盒 | 3680 家登 | 463 | 55.90 |
| 濕製程設備 | 3131 弘塑 | 1,540 | 67.00 |
| 濕製程設備 | 3583 辛耘 | 405.5 | 45.60 |
| 揀晶設備 | 6187 萬潤 | 295.5 | 96.70 |
| 測試探針卡 | 6515 穎崴 | 1,050 | 70.20 |
| 測試探針卡 | 6223 旺矽 | 555 | 36.70 |
| IC 載板 | 3037 欣興 | 183.5 | 27.10 |
| PCB 基板 | 2316 楠梓電 | 50.6 | 8.80 |
台股 CoWoS 概念股以台積電(2330)為首,分別有 CoWoS 設備廠商辛耘(3583)、萬潤(6187)、弘塑(3131),EUV 光罩盒廠商家登(3680),IC 載版廠欣興(3037),PCB 基板楠梓電(2316)與 CoWoS 封裝廠商日月光投控(3711)、精材(3374)。
CoWoS 是什麼?
CoWoS 是 Chip on Wafer on Substrate 的縮寫,是由台積電(TSMC)推出的整合型的封裝技術,共分成 CoW 跟 WoS 前後兩個製程。
先將半導體晶片透過 Chip on Wafer(CoW)的封裝製程連接至矽晶圓,再把此 CoW 晶片與基板連結,整合而成 CoW-on-Substrate。
這種技術旨在將多個獨立的晶片集成在一起,然後再封裝到一個基板上,實現更高效的運算和更小的體積。
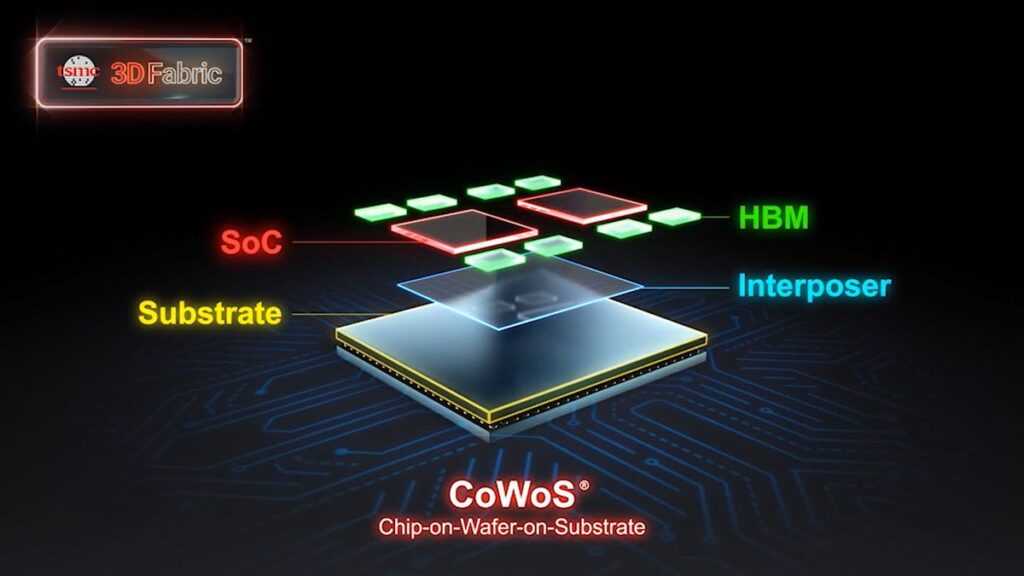
CoWoS 先進封裝是兩個技術的結合,可以分成「CoW」和「WoS」:
- CoW 全名為「Chip-on-Wafer」,是指將晶片堆疊的技術。
- WoS 全名為「Wafer-on-Substrate」,是指將晶片堆疊、封裝在基板上。
CoWoS 名詞介紹
晶片(Chip):
- 晶片是半導體元件,用來執行特定功能,如處理數據或存儲信息。
晶圓(Wafer):
- 晶圓是用來製造晶片的圓形薄片,一個晶圓上可以製造出很多晶片。
基板(Substrate):
- 基板是用來支撐和連接這些晶片的底座,通常由高性能材料製成,能提供良好的散熱和電氣連接。
CoWoS 封裝技術
CoWoS 屬於半導體先進製程的一種,可以分成下面三個製造階段:
晶片製造:
- 首先在晶圓上製造出許多晶片,每個晶片都有自己的特定功能。
晶片在晶圓上的整合:
- 將這些製造好的晶片排列並固定在晶圓上,這個過程中需要非常精確的對位和連接技術。
封裝在基板上:
- 最後,將整個晶圓封裝到基板上,這個基板提供了電氣連接和機械支撐。
三種 CoWoS 封裝技術:CoWoS-S、CoWoS-R、CoWoS-L
台積電 CoWoS 技術往下又可以細分成 CoWoS-S、CoWoS-R、CoWoS-L,差別在於中介層使用的材料以及可封裝的 HBM 數量。
目前市面上主流為 CoWoS-S,不論是AI伺服器、高效能運算產品,例如:輝達的 H100 以及 AMD 的 MI300 皆使用 CoWoS-S,但缺點是生產成本過高,且良率較低。
CoWoS-R 透過 InFO 技術、中介層,將各 SoC、HBM 異質整合,取代了中介層中的矽穿孔,可進一步降低整體封裝成本,適合網通類產品使用。
CoWoS-L 為目前台積電最新技術,在矽中介層中加入主動元件 LSI,提升晶片設計及封裝彈性,可以堆疊多達 12 顆 HBM3,而成本比 CoWoS-S 還低,預計在 2024 年會推出,新一代 AI 晶片有機會使用,有望成為未來 CoWoS 技術主流。
為何需要 CoWoS?
隨著 AI 技術的需求提升,現在晶片的算力越來越高,原本的晶片效能已經無法應付。
要提升單位面積下的晶片效能,只有 2 種方式:
- IC 設計技術進步,讓單位晶片效力提高。
- 半導體製程技術進步,在同樣面積下裝入更多的電晶體。
隨著晶片尺寸已逼近物理極限,為了延續摩爾定律,半導體產業開始將重心轉往後端製程發展,也就是封裝。
傳統晶片設計只是在平面切出更小的晶圓,現在的先進封裝則是往上堆疊,也就是所謂的 2.5D 或 3D封裝。
先進封裝的好處
先進封裝的好處有提升運算速度、節省空間、降低能耗和更好的散熱性能幾點。
提升運算速度:
- 多個晶片一起工作,比單個晶片更快,能處理更多數據。
節省空間:
- 讓晶片更緊湊地排列在一起,不佔用太多地方,適合用於小型設備。
降低能耗:
- 由於晶片之間的距離縮短,數據傳輸的效率更高,能耗更低。
更好的散熱性能:
- 基板材料和封裝技術能有效地將熱量散出,保持晶片在最佳工作溫度下運行。
CoWoS 應用領域
CoWoS 可以應用的領域包含 AI 人工智慧、雲端計算、伺服器、數據中心、電動車自動駕駛等。
人工智慧(AI):
- AI 需要大量數據處理和運算,使用 CoWoS 技術能提高 AI 晶片的效能,讓 AI 系統更智能、更快速。
數據中心:
- 數據中心需要處理海量數據,使用 CoWoS 技術能提高服務器的運算速度和效率,降低運營成本。
高性能計算(HPC):
- 高性能計算系統需要強大的運算能力,用於科學研究、模擬計算等,CoWoS 能提供所需的高效能。
其他先進封裝技術
除了台積電的 CoWoS 技術除外,其實還有其他不同種的封裝,像台積電還有 InFO-L 封裝,Intel 的 EMIB、Co-EMIB、Foveros。
三星(Samsung)也有 I-Cube 和 X-Cube 等先進封裝技術,台灣公司群創(3481)最近也推出 FOPLP 扇出型面板級封裝。
InFO-L 封裝
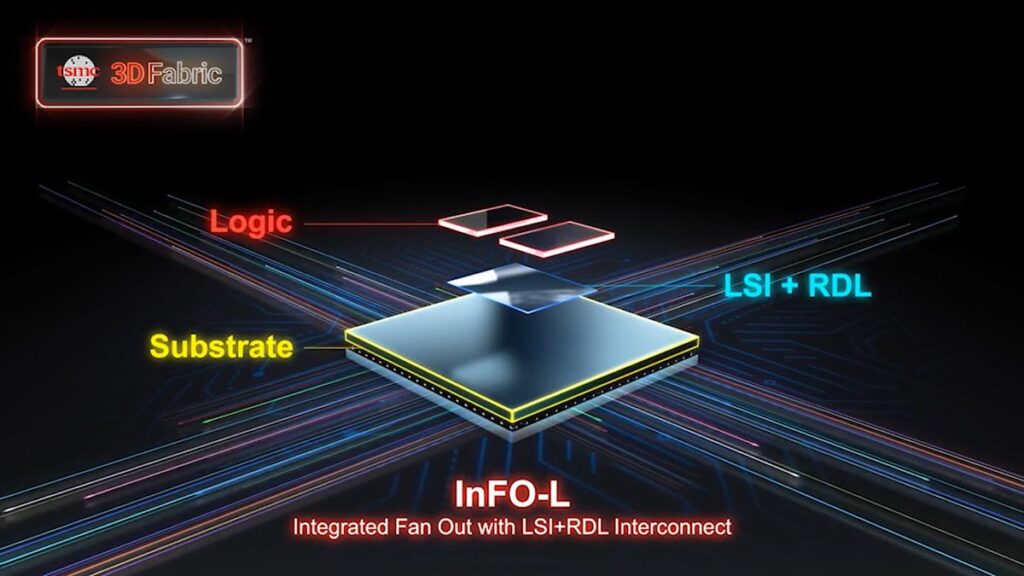
群創(3481) FOPLP 扇出型面板級封裝技術
FOPLP 全名為 Fan-Out Panel-Level Packaging 扇出型面板級封裝技術,把原本圓形切割的晶圓變成方形切割,可以減少邊邊角角的浪費,提升單位晶圓的使用效率。
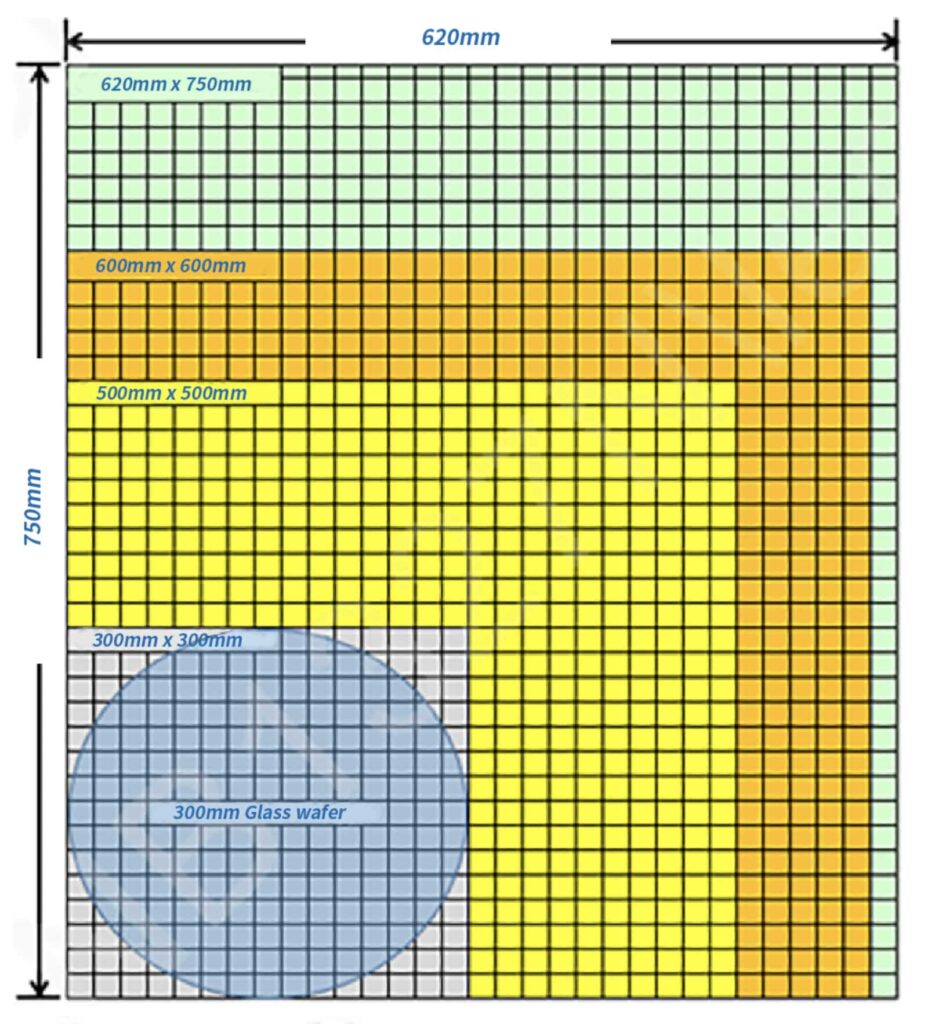
CoWoS 封裝技術未來的發展
受惠於 AI、HPC 的產業的高階晶片需求,目前台積電在 2024 第二季法說會中表示 CoWos 需求仍非常強,台積電與合作封測夥伴會繼續擴增產能。
台積電總裁魏哲家表示預計 2025-2026 年 CoWos 產能有機會達到供需平衡,根據 Yole Développement的產業分析報告顯示:到 2027 年先進製程年複合成長率高達 10%。
2021 年先進封裝市場規模為 380 億美元,其中先進封裝的市場佔所有 IC 封裝市場的份額為 44%。
預計 2027 年先進封裝市場將成長至 650 億美元,換算年複合成長率 CAGR 為 10%,且占據所有 IC 封裝的市場份額將成長至 50% 以上。
CoWoS 常見問題
💡延伸閱讀>矽光子是什麼?台股矽光子概念股有哪些?12 檔概念股一次看
💡新手必看>殖利率是什麼?怎麼算?2024股票高殖利率排行一次看!
💡常見問題>興櫃上櫃上市股票差別?該如何買賣?